IONTOF Time of Flight SIMS
The IONTOF Time-of-Flight Secondary Ion Mass Spectroscopy (ToF-SIMS) system uses Bi ions to directly chemically image sample surfaces.
Synchronized sputtering by integrated O or Cs ion beams allows depth profiles down to several microns.
Molecular masses from 1 up to >5000 amu (i.e., H up to large molecules) can be detected with a very high mass resolution (i.e., >1000 m/dm).
The system can detect trace elements down to concentrations of a few parts per million.
The software can produce 2-D and 3 -D chemical reconstructions of analyzed areas.
Lateral resolution is as small as ~300 nm, vertical resolution is ~ 2nm.

Image One
High mass resolution gives ability to distinguish – from left to right above – O, NH2, 13^CH3, and CH4 despite just a 0.035 amu total mass separation.
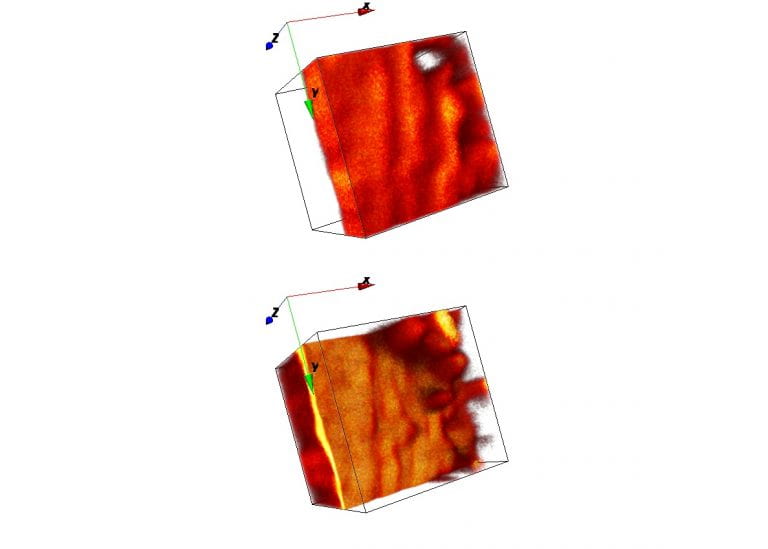
Image 2
Software can reconstruct elemental spatial distribution to create 3D images of a Ta cap(above-top) and Pt bulk (above-bottom) in an evaporator pellet.
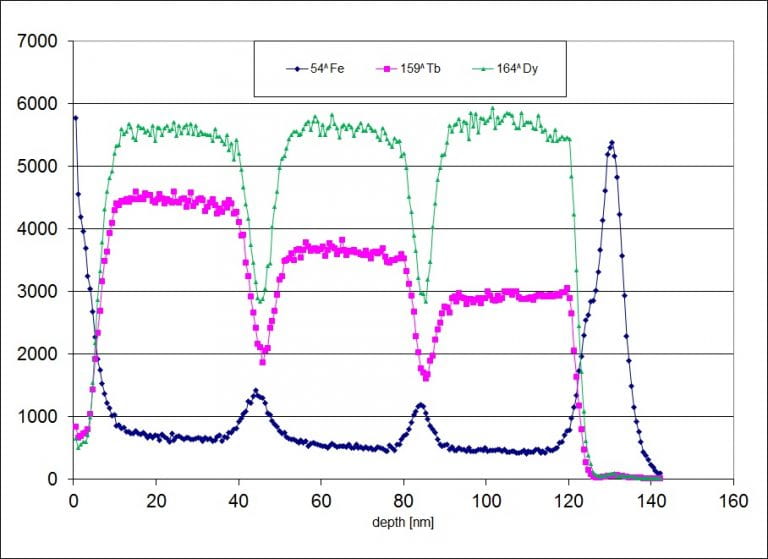
Image 3 depth prof
Depth profile of Terfenol-D sample reveals multilayered structure and variation in layer growth conditions.
